激光烧蚀与 Xe PFIB-SEM 配对:在半导体工业大规模物理失效分析中实现精确终点的方法
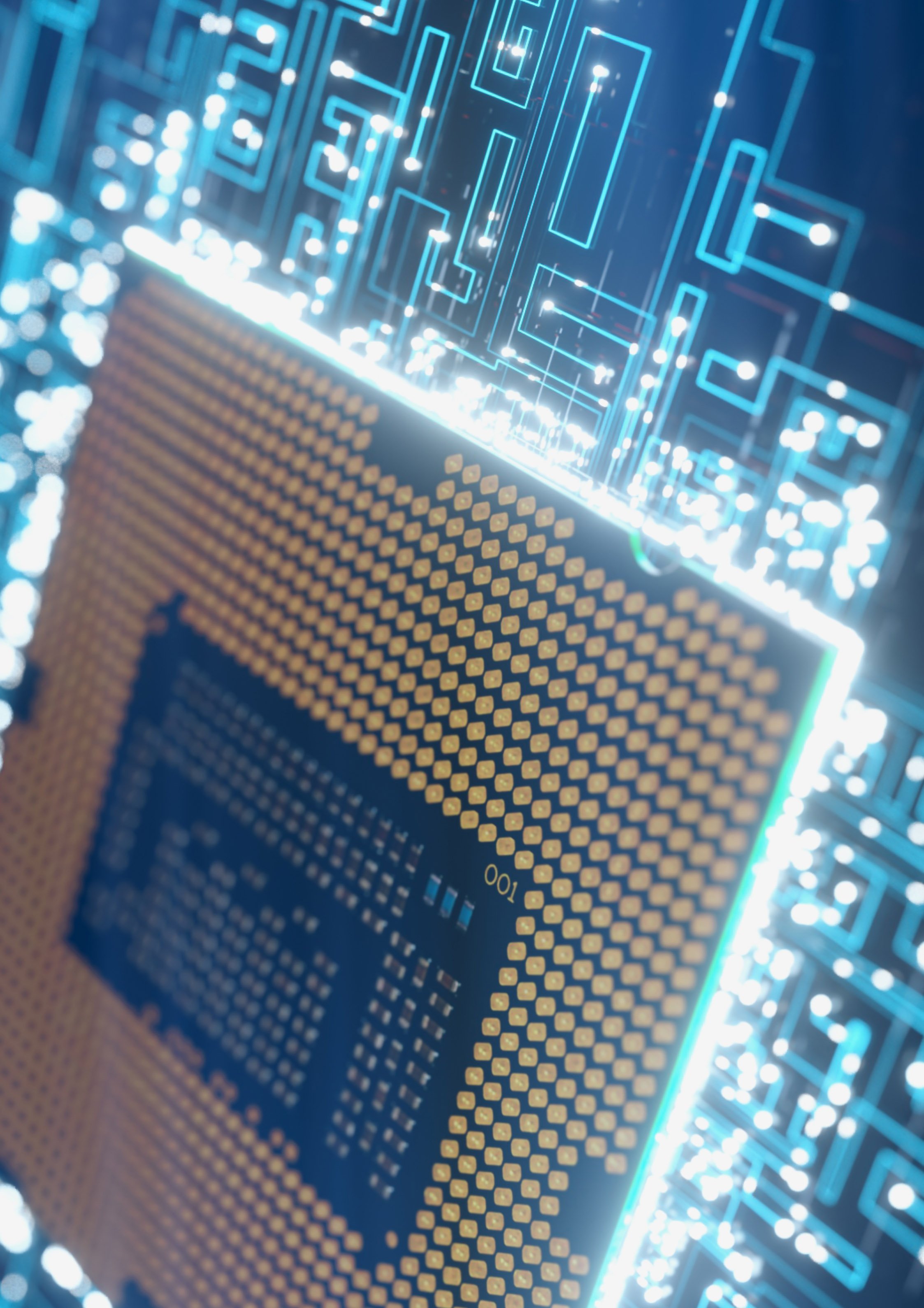
您想减少失效分析样品制备的时间和成本吗?
Rodrigo Delgadillo Blando 等人在 2021 年 ISTFA 会议上发表的论文 "Pairing Laser Ablation and Xe Plasma FIB-SEM:An Approach for Precise End-Pointing in Large-Scale Physical Failure Analysis in the Semiconductor Industry "介绍了一种使用ps 激光切割工具和 Xe Plasma FIB-SEM 系统制备微电子器件大体积横截面的创新方法。这是一项非常相关的前沿研究,旨在提高微电子器件失效分析的效率和准确性。
作者探讨了在微电子器件中获取深埋结构进行物理失效分析 (PFA) 所面临的挑战。传统方法,如机械抛光或 Ga+ FIB 铣削,要么速度太慢,要么对大容量样品制备的破坏性太大。本文提出了一种方法,将ps 激光烧蚀工具的快速材料去除率与氙等离子 FIB-SEM 系统的精确端点和精细表面抛光能力相结合。论文提出,这种方法能够快速、准确地对微电子器件进行 PFA 处理,而且由于两种工具可同时连续运行,还能提高生产率。
 该研究证明了所提方法在各种应用中的有效性,例如制备由敏感材料和复杂结构组成的 AMOLED 移动显示屏的无损伤和无分层横截面。本文还讨论了制备具有不同焊球材料和尺寸的倒装芯片封装的横截面(需要高分辨率成像和分析),以及用于端点定位的 CAD 导航、数据关联和位图叠加。用于端点定位的 CAD 导航、数据关联和位图叠加。
该研究证明了所提方法在各种应用中的有效性,例如制备由敏感材料和复杂结构组成的 AMOLED 移动显示屏的无损伤和无分层横截面。本文还讨论了制备具有不同焊球材料和尺寸的倒装芯片封装的横截面(需要高分辨率成像和分析),以及用于端点定位的 CAD 导航、数据关联和位图叠加。用于端点定位的 CAD 导航、数据关联和位图叠加。
论文还涉及相关问题,如 CAD 导航、数据关联和用于端点的位图叠加。论文表明,所提出的方法可以生成高质量的横截面,并将伪影和损伤降到最低,还能揭示裂纹、空洞、金属间化合物和分层等缺陷。
利用 TESCAN 解决方案优化您的半导体失效分析: 利用 TESCAN 解决方案掌握集成电路封装失效分析
了解这项引人注目的研究:激光烧蚀与 Xe PFIB-SEM 配对:在半导体行业大规模物理故障分析中实现精确终点的方法 | ISTFA 论文集 | ASM 数字图书馆 (asminational.org)
利用 TESCAN 解决方案优化您的半导体失效分析: 利用 TESCAN 解决方案掌握集成电路封装失效分析

探索最新的半导体技术
与业界专业人士、研究人员和学者一起探索半导体的未来。我们的专家团队期待与业界专业人士、研究人员和学者进行交流,了解您的需求,并讨论 TESCAN 的解决方案如何支持您的研发计划。
