掌控IC封装失效分析,
采用TESCAN解决方案
感受等离子FIB-SEM的实力
体验TESCAN大体积工作流程的创新
新文件
优化半导体失效分析:激光切割和Xe PFIB-SEM相结合的力量
释放独立ps激光切割与Plasma FIB-SEM相结合的全部潜力,使微电子器件的快速和准确的失效分析比以前更容易。在我们最新的论文中,了解如何通过同步、连续的系统操作来最大限度地提高生产力!

随着半导体产业的发展,IC封装失效分析实验室面临着全新的挑战。为了应对日益复杂的半导体产品失效分析需求、不断发展的封装结构、产品尺寸的不断缩小以及出现的特殊的敏感材料是一项艰巨的任务。与此同时,全球半导体公司竞相为尖端的通信设备和多功能消费电子产品开发所需的最先进的芯片、封装和小芯片间的互联。
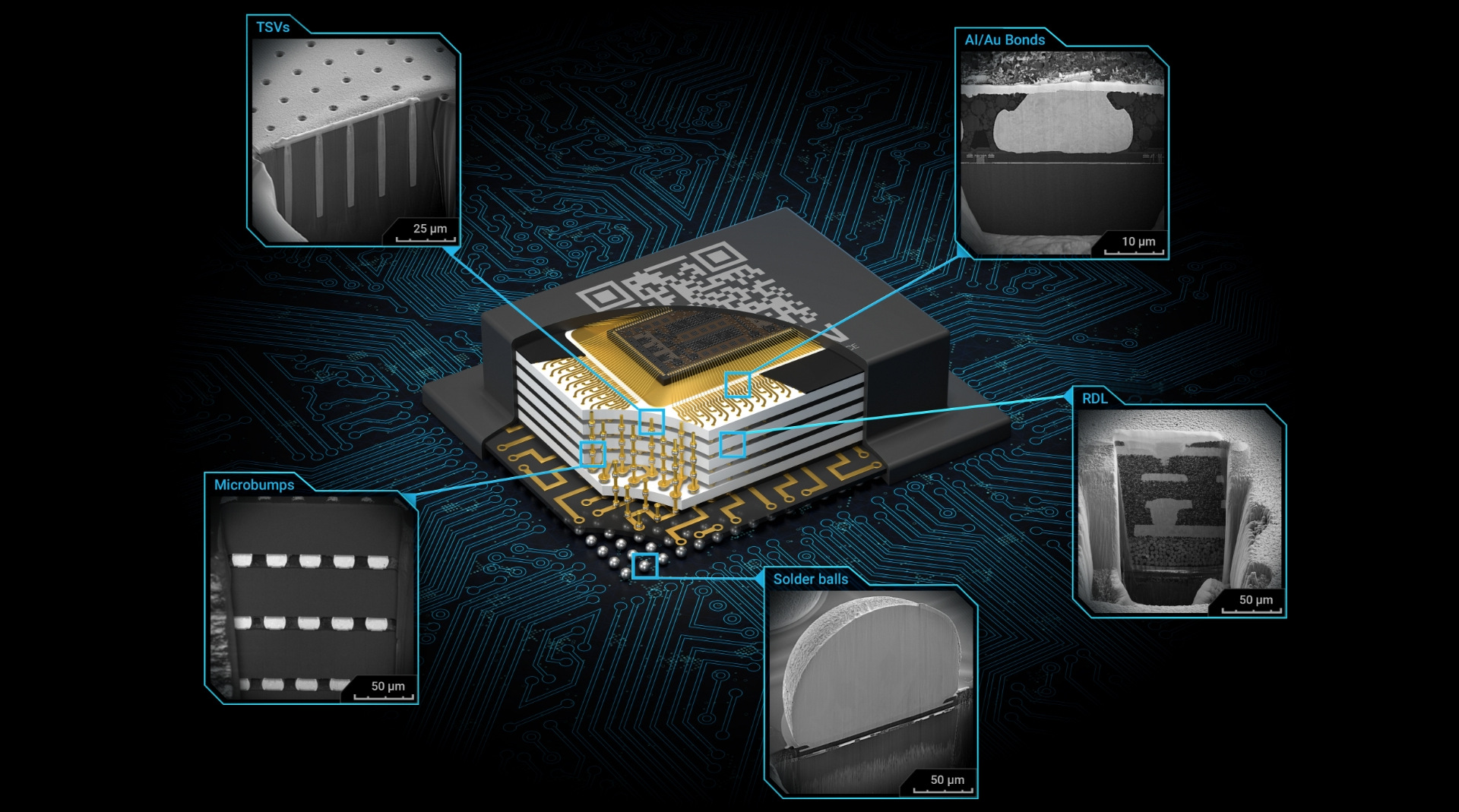
用最先进的TESCAN解决方案改造可持续的IC封装失效分析
可持续的IC封装失效分析取决于多样化的专业知识和FA设备所提供的广泛的无损和破坏性分析程序。TESCAN以创新的解决方案支持其客户,包括无损的显微CT(显微CT)失效分析应用、PFIB-SEM SOLARIS X,以及将激光切割和 PFIB-SEM 技术无缝结合的大体积工作流程。
此外,TESCAN与欧洲的合作伙伴一起,作为FA4.0项目的一部分,该项目寻求在众多的失效分析设备中建立一个更流畅的失效分析工作流程,并为微电子行业的失效分析实验室的数字化进行数据管理。更多关于FA4.0的信息,请参见我们的 "技术动态"部分。
亲眼见证这些解决方案如何使IC封装失效分析达到一个新的水平
发现我们最先进的解决方案
有疑问吗?
对在线做样感兴趣吗?
我们全球团队随时准备回答有关TESCAN FIB-SEM和半导体和IC封装失效分析解决方案的问题。

